行业新闻
行业新闻


在宽禁带半导体材料领域,碳化硅(SiC)晶体的质量直接影响着功率器件的性能表现。为实现高品质SiC晶体的制备,必须建立完善的缺陷评估体系,这涉及籽晶筛选、生长工艺优化以及外延缺陷控制等多个关键环节。目前,SiC晶体缺陷检测技术已形成破坏性和非破坏性两大技术路线,各自具有独特的应用优势和技术特点。
一、破坏性检测技术体系
1. 化学腐蚀分析法
该方法利用高温熔融碱溶液对晶片表面进行选择性腐蚀,通过不同形貌的腐蚀坑来识别位错类型。研究表明,Si面典型腐蚀坑可分为三类:近圆形(对应螺位错TEDs)、规则六边形(对应刃位错TSDs)以及特征贝壳形(对应基平面位错BPDs)。现代检测设备如三维激光共聚焦显微镜、数字图像处理系统等,能够实现腐蚀坑的自动化统计和三维重构,显著提高了位错密度测量的准确性和效率。

TSDs、TEDs、BPDs的腐蚀坑形貌图
2. 透射电子显微技术
TEM技术凭借其纳米级分辨率优势,可直观呈现晶体内部的微观缺陷结构。特别在异质界面分析方面,TEM能清晰观测到位错线的延伸、增殖等动态行为,为理解晶体生长过程中的缺陷演化机制提供了直接证据。该技术对BPDs向TEDs的转化、堆垛层错(SFs)的形成等关键过程具有独特的解析能力。

不同衍射矢量下,籽晶和生长晶体界面处位错的 TEM
二、非破坏性检测技术进展
1. 光谱分析技术
阴极荧光(CL)和光致发光(PL)技术通过检测缺陷相关的特征发光谱线实现无损检测。CL技术因其宽光谱探测范围(200-1600nm),特别适合宽带隙材料的缺陷分析。最新研究表明,通过低温CL测量可区分不同深能级缺陷的发光特征,实现位错类型的精准鉴别。
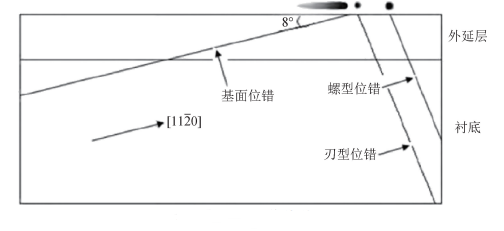
位错在CL图像中的原理
2. X射线衍射形貌术
同步辐射单色束X射线形貌术(SMBXT)采用高准直度的同步辐射光源,结合双晶单色器系统,可获得<1弧秒的角度分辨率。该技术通过记录样品不同布拉格角位置的衍射强度分布,可重建晶体内部的应变场和位错网络,特别适用于大尺寸晶片的全场检测。

PL 法检测位错。& (a)4H-SiC 的 TSD、TMD、TED、无位错区测得的 PL 光谱;(b),(c),(d)TED、TSD、TMD的光学显微镜图像与 PL强度映射图; (e)BPDs 的 PL 图像
3. 新型光学检测方法
(1)光应力检测技术:基于光弹性效应,通过定量测量晶体双折射分布来反映应力场与位错的对应关系,检测分辨率可达10μm级别。
(2)拉曼光谱技术:研究发现796cm-1特征峰与微管(MP)、TSDs和TEDs存在明确关联,通过共聚焦拉曼成像可实现亚表面缺陷的三维定位。

光应力技术对 SiC 单晶衬底的表征 & MP、TSD、TED的拉曼散射峰位图
三、技术发展趋势
当前检测技术正向多模态联用方向发展,如XRT与CL的协同分析、PL与拉曼的共定位测量等。此外,人工智能技术的引入显著提升了缺陷识别的自动化水平,基于深度学习的图像处理算法可实现复杂缺陷形貌的智能分类。这些技术进步为SiC晶体生长工艺的精准调控提供了强有力的表征支撑。
四、结语
上海知明科技半导体材料科技有限公司专注于高端半导体材料的研发、生产和销售,致力于为客户提供高品质的蓝宝石衬底、碳化硅(SiC)晶圆、单晶硅片、SOI晶圆等核心材料。我们还可以提供超大尺寸单晶硅、柱状多晶硅,并可定制加工各种类型硅部件、硅锭、硅棒、硅环、硅聚焦环、硅筒、硅排气环。我们拥有先进的加工设备和成熟的技术工艺,可根据客户需求提供定制化解决方案,包括特殊尺寸切割、抛光、薄膜沉积等精密加工服务。凭借稳定的供应链体系和严格的质量控制,我们为半导体、光电子、功率器件等领域提供可靠的衬底材料支持,助力客户在5G通信、新能源汽车、智能传感等前沿科技领域实现突破。